반도체 패키징 기술
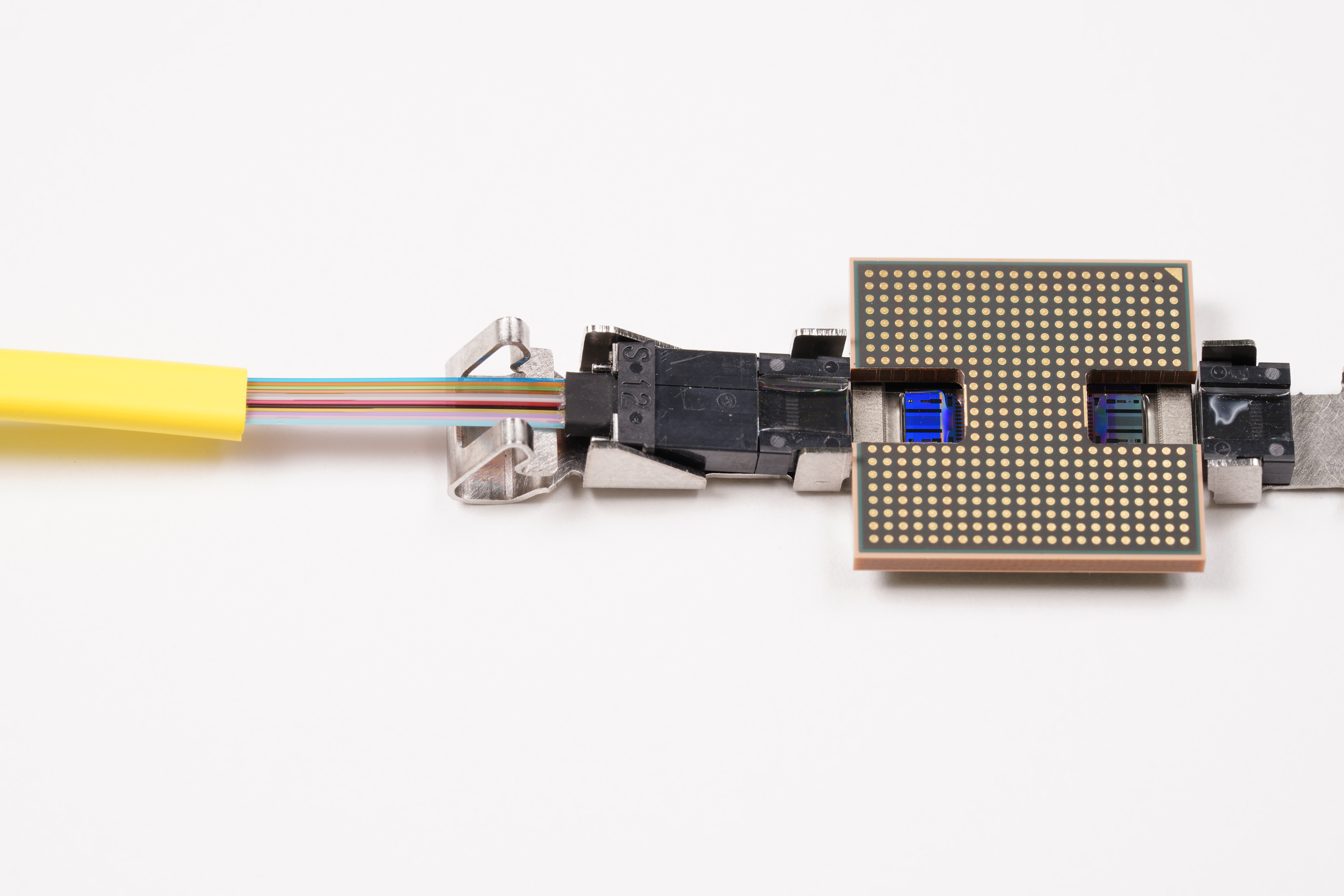
IBM은 칩렛 및 고급 패키징 기술 기능을 개발하여 AI 및 로직 혁신을 강화합니다.
패키지 수준에서 다양한 기술을 통합하여 성능을 높이고 비용을 절감하는 프레임워크는 반도체 혁신을 위한 새로운 패러다임과 증가하는 AI의 성능 요건을 충족하는 새로운 길을 제공합니다.
IBM의 캐나다 Bromont 시설에서는 세계에서 가장 진보된 반도체를 IBM 시스템 전체 라인과 OEM 고객이 생산하는 광범위한 제품에 사용하는 최첨단 마이크로 전자 부품으로 변환합니다.
50년 이상의 패키지 조립 및 테스트 경험을 보유한 Bromont은 북미 최대의 아웃소싱 반도체 조립 및 테스트(OSAT) 시설이자 캐나다에서 가장 큰 수출업체 중 하나로, 매주 100,000개 이상의 고급 플립 칩 모듈을 제조합니다.
기능
fcBGA 및 SiP 초점
- 패키지 크기 15mm~93mm(최대 105mm의 콘셉트 증명)
- 다이 크기 2x2mm~27x32mm
- 400A 이상 설계 패키징 지원
- 400W 이상 열 솔루션 지원
- SiP, AoP SiP 및 하이브리드 SiP
- 다이 닫기 및 부품 위치 지정
- 더 높은 너비와 더 낮은 전력
- 더 나은 신호 무결성
- 더 작은 시스템 레벨 풋프린트
- 모듈당 400개 이상의 부품
- 모듈당 23개 이상의 서로 다른 PN
- 양면 부품
- 디지털, 아날로그, 혼합 신호, RF
- 모듈, 웨이퍼 및 시스템 레벨 테스트 개발 및 특성화
- 다중 사이트 프로그래밍
- 테스트 시간 단축
- 테스트 프로그램 마이그레이션
- 테스트 패턴 변환(STIL, WGL)
- 프로브 카드, 로드 보드, 시스템 레벨 테스트(SLT) 보드 설계, Fab 및 검증
- 온로드 보드 테스트 솔루션
설계
- 시스템 수준 통합 사고방식
- 캐나다 CGP에 따라 ITAR을 준수하는 설계 팀
- 최첨단 설계 도구 세트
- 맞춤형 자동화 및 검사
특성화
- 전체 기술 스택을 통한 업계 최고의 분석 기술
- 물리적 장애 분석
- 재료 구성
- 프로세스 특성화
모델링
- 광범위한 경험 기반 패키지 안정성 인사이트
- 수학적 독점 알고리즘, 코드, 속성 및 모델
- 제조 데이터와 통계적으로 연결된 예측 신뢰도 범위
CPO - CSPO 턴키 솔루션
- EIC + PIC 어셈블리
- 광섬유 어레이 연결
- CSOP 테스트
- CPO/SiP 어셈블리
- CPO/SIP 테스트
CPO 개발 하이라이트
- 섬유 밀도 증가
- 125μm 피치, 80μm 섬유 직경
- 35개의 섬유로 된 리본 조립
- 레이저 부착
- 온다이 레이저
- 통합 커넥터
50년 이상의 기술 개발 및 제조 경험
1972년: Bromont 현장 개관
1996년: 전 세계 게이밍 콘솔 프로세서 공급업체로 성장
2016년: z13 시스템 - 오가닉 기반의 8코어 칩 5.2Ghz
2018년: SiP, 소형 카드 – Z 프로그램 – 암호화 하드웨어
2022년: 50주년
항공우주 및 방위 산업을 위한 특정 환경
ITAR
- 공인 엔지니어링 및 제조 인력
- 제조 현장 보안 액세스 제어
- 시스템 추적 자동화, 안전한 스토리지, 구성 요소 추적성 통과 및 거부
- 접수부터 배송까지 전적으로 책임지는 서비스
제어된 미분류 정보(CUI)
- 모든 ITAR 제어 구현
- CUI에 대한 특별한 요구 사항을 해결하는 전담 팀
- 제품 등에 대한 추가 보고 및 모니터링
SECRET
- 모든 ITAR 및 CUI 제어 구현
- 국방부 기밀 업무에 대한 특수 요구 사항을 해결하는 전담 팀입니다.
IBM 에코시스템: 개발에서 HVM까지
MRL의 재료 합성부터 조립 및 테스트에 이르기까지 전체 프로세스 흐름 역량을 갖추고 있으며, 하이브리드 본딩, HD 기판 지원 및 dBHI 브리지 기술을 통한 3DHI 기술 구현에 중점을 두고 있습니다. IBM Bromont와 OEM은 고급 플립십, SiP 및 테스트 생산을 위해 IBM과 외부 고객 모두에게 서비스를 제공하는 50년의 제조 경험을 보유하고 있습니다.
퀘벡의 청정 에너지 이점
풍부한 청정 에너지
- 이 지역은 깨끗하고 재생 가능한 에너지원인 수력 발전에 크게 의존하고 있습니다.
- 퀘벡에서 생산되는 전체 에너지의 99%는 재생 가능 에너지입니다.
- 퀘벡의 수력 발전소에서 배출되는 온실 가스(GHG)는 석탄 화력 발전소보다 70배 적습니다.
청정 에너지 그리드
- 퀘벡은 세계에서 탄소 집약도가 가장 낮은 전력망을 보유하고 있습니다.
- 북미에서 가장 큰 규모를 자랑하는 퀘벡의 전력망은 세계에서 가장 신뢰할 수 있는 시스템 중 하나입니다.
- 2013년부터 퀘벡은 기후 변화에 대처하기 위해 온실 가스 배출 캠 앤 트레이드 시스템(SPEDE)을 시행하고 있습니다.
풍부한 물 공급
- 퀘벡은 반도체 산업에 필수적인 풍부한 담수 자원에 접근할 수 있습니다.
지속가능성을 위한 정부의 노력
- 퀘벡 정부는 2030년까지 온실가스(GHG) 배출량을 1990년 수준보다 37.5% 감축하기로 약속했습니다.
- 퀘벡주는 또한 2050년까지 탄소 중립을 달성하기로 약속했습니다.
개발 랩
노스이스트 코리더에 위치한 IBM의 개발 연구소는 컴퓨팅의 미래를 위한 반도체 기술 혁신을 주도하고 있습니다.
1,500명 이상의 과학자, 엔지니어가 근무하며 차세대 컴퓨팅을 설계하는 세계 최대 규모의 산업 연구 기관입니다.
100,000평방피트 규모의 반도체 팹 공간으로, 현장에서는 업계 최대의 혁신이 이루어지고 있습니다.
IBM Bromont는 C2MI와의 파트너십을 활용하여 70개 이상의 장비 제조업체가 제공하는 최첨단 장비를 활용합니다.
Bromont 뉴스
AI 및 클라우드 컴퓨팅의 발전으로 칩에 대한 수요가 계속해서 급증함에 따라 캐나다와 퀘벡 정부는 IBM과 협력하여 퀘벡 브로몬트에 있는 IBM 공장의 조립, 테스트 및 패키징 기능을 발전시킴으로써 북미 칩 공급망의 미래를 공고히 하고 있습니다. 이들 3개 기업은 공장의 조립, 테스트 및 패키징 역량을 발전시키는 데 최대 1억 8,700만 캐나다 달러를 투자할 예정이며, 이를 통해 IBM은 확장 가능한 제조 및 기타 고급 조립 프로세스를 위한 방법에 대한 연구 및 개발을 추진할 수 있습니다.
Bromont는 반도체 패키징 및 테스트 프로세스를 스마트 제조의 최전선으로 끌어올리기 위해 2024년 5월에 출시될 예정인 디지털 혁신의 여정에 착수하고 있습니다. 해당 이니셔티브는 강력한 데이터 패브릭 기반을 구축하여 고급 AI/ML 기술의 통합을 촉진합니다. 스마트 팩토리는 품질 검사에 필요한 예측 및 실시간 모니터링을 가능하게 하고 빅 데이터 분석을 활용하여 장비 고장을 사전에 예측합니다. 또한 중요한 데이터와 통찰력을 중앙 집중화하기 위해 컨트롤 타워를 구현하여 관리 수준 전반에 걸쳐 정보에 입각한 의사 결정을 내릴 수 있습니다. 이러한 자산 성능 및 품질 관리 개선을 통해 Bromont는 운영 효율성과 신뢰성을 개선하여 업계의 새로운 표준을 설정하는 것을 목표로 합니다.
1단계는 첨단 fcBGA 패키징 기술의 조립 및 테스트 용량을 늘리는 동시에 Si Photonics 기술 조립에 필요한 용량을 추가하는 것을 목표로 합니다. 확장 계획의 1.5단계에서는 2026년 하반기까지 웨이퍼 범핑 및 팬아웃 웨이퍼 레벨 패키징 기능을 추가할 예정입니다. 이 추가는 실험실-팹 시너지 효과를 위해 IBM 연구 센터와의 협업을 활용하는 R&D 및 대량 제조를 위한 완전한 북미 솔루션을 만들 것입니다. 또한 IBM은 IBM Bromont옆에 위치한 개발 파트너인 C2MI와 협력하여 2.5D Si 인터포저 및 3D 솔루션을 위한 웨이퍼 마감 작업을 추가하는 계획을 마무리하고 있습니다. C2MI 사이트에 추가된 이 제품의 생산도 2026년 하반기로 예정되어 있습니다.
반도체에 대해 읽은 적이 있다면 웨이퍼를 들고 있는 사람의 사진을 본 적이 있을 것입니다. 수백 개의 미래 컴퓨터 칩이 포함된 실리콘 디스크입니다.
당사는 반도체 제조의 최소 길이 규모(<20nm)와 최대 길이 규모(>20mm) 모두에 적합한 신소재를 개발하고 있습니다.
IBM과 ASMPT의 연구원들은 두 칩렛 사이에 필요한 I/O 상호 연결 본딩 크기를 획기적으로 줄여 수많은 새로운 컴퓨터 칩 설계를 위한 길을 닦는 하이브리드 본딩 기술로 이정표를 세웠습니다.